Atom kuch mikroskopiyasi
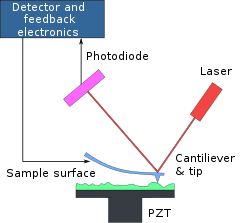
Umumiy koʻrinish[tahrir | manbasini tahrirlash]

Atom kuch mikroskopiyasi [1] (AKM) skanerlovchi zond mikroskopining (SZM) bir turi boʻlib, nanometr fraksiyalari tartibi boʻyicha koʻrsatilgan oʻlchamlari optik diffraktsiya chegarasidan 1000 baravar yaxshiroq. Ma'lumotlar mexanik zond yordamida sirt yuzani "tegish" orqali yig'iladi. (Elektron) buyruq bo'yicha kichik, ammo aniq harakatlarni osonlashtiradigan piezoelektrik elementlar aniq skanerlashni ta'minlaydi. Nomiga qaramay, Atom Kuchlari Mikroskopi yadro kuchidan foydalanmaydi.
Qobiliyatlar[tahrir | manbasini tahrirlash]
Quvvatni o'lchashda AKMlar zond va namuna o'rtasidagi kuchlarni ularning o'zaro ajralish funktsiyasi sifatida o'lchash uchun ishlatilishi ham mumkin. Bu kuch spektroskopiyani amalga oshirish, xususiyatlarni o'rganish va o'lchash uchun qo'llanilishi mumkin, masalan, namunaning Young moduli, qattiqlik o'lchovi.
Tasvirga olish uchun zondning namuna unga ta'sir qiladigan kuchlarga reaktsiyasi yuqori aniqlikda namuna yuzasining uch o'lchovli shakli (topografiyasi) tasvirini yaratish uchun ishlatilishi mumkin. Bunga namunaning uchiga nisbatan holatini rastrli skanerlash doimiy o'zaro ta'siriga mos keladigan zond balandligini qayd etish orqali erishiladi .
Topografik tasvirlarni olish bilan bir vaqtda, ko'pincha shunga o'xshash yuqori aniqlikda namunaning boshqa xossalari mahalliy darajada o'lchanishi va tasvir sifatida ko'rsatilishi mumkin. Bunday xususiyatlarga misollar qattiqlik yoki yopishish kuchi kabi mexanik xususiyatlar va o'tkazuvchanlik yoki sirt potentsiali kabi elektr xususiyatlarni keltirishimiz mumkin.[2][3]
Konfiguratsiya[tahrir | manbasini tahrirlash]
Rasmda AKM ko'rsatilgan, u odatda quyidagi xususiyatlardan iborat.[4] Qavslar ichidagi raqamlar rasmdagi raqamlangan xususiyatlarga mos keladi. Koordinata yo'nalishlari koordinatalar tizimi (0) bilan belgilanadi.
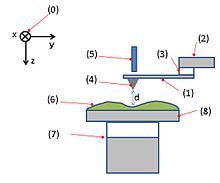
(1) : Konsol, (2) : Konsol uchun tayanch, (3) : Pyezoelektr element (konsolni o'z chastotasida tebranish uchun), (4) : Maslahat (konsolning ochiq uchiga mahkamlangan, zond vazifasini bajaradi), (5) : Konsolning burilish va harakatini detektori, (6) : AFM bilan o'lchanadigan namuna, (7) : xyz drayveri, (namuna (6) va bosqichni (8) x, y va z yo'nalishlarida harakatlantiradi) uchi cho'qqisiga nisbatan (4) va (8) : Bosqich.
Kichik prujinaga o'xshash konsol (1) tayanch (2) tomonidan olib boriladi piezoelektrik element (odatda keramik materialdan qilingan) (3) konsolni (1) tebranadi. O'tkir uchi (4) konsolning bo'sh uchiga o'rnatiladi. Detektor (5) konsolning burilishini va harakatini qayd qiladi. Namuna (6) namuna bosqichiga (8) o'rnatiladi. X y z o'qi (7) namunani (6) va namuna bosqichini (8) uch cho'qqisiga (4) nisbatan x, y va z yo'nalishlarida almashtirishga imkon beradi. Rasmda namunaga biriktirilgan haydovchi ko'rsatilgan bo'lsa-da, haydovchi uchiga ham biriktirilishi mumkin yoki mustaqil drayvlar ikkalasiga ham biriktirilishi mumkin, chunki bu namuna va uchning nisbiy siljishi nazorat qilinishi kerak.

(1) : uchi cho'qqisi, (2) : Namuna yuzasi, (3) : uchi cho'qqisining Z-orbitasi, (4) : Konsol.
Tarix[tahrir | manbasini tahrirlash]
Atom kuch mikroskopi 1985 yilda IBM olimlari tomonidan yaratilgan.[5] AFM ning kashf etilishi, skanerlash tunnel mikroskopi (STM) Gerd Binnig va Geynrix Rorer tomonidan 1980-yillarning boshida IBM Research - Zurich kompaniyasida ishlab chiqilishi bo'ldi. Bu ixtiro orqali ular 1986-yili fizika bo'yicha Nobel mukofotini qo'lga kiritishgan Binnig [4] atom kuchi mikroskopida birinchi eksperimental amaliyot 1986 yilda Binnig, Quate va Gerber tomonidan amalga oshirildi [6]
Savdoga chiqarilgan birinchi atom kuch mikroskopi 1989 yilda taqdim etilgan. AFM nano miqyosda materiyani tasvirlash, o'lchash va manipulyatsiya qilish uchun eng muhim vositalardan biridir.

Tasvirlash rejimlari[tahrir | manbasini tahrirlash]
AFM ishi odatda uchi harakatining tabiatiga ko'ra uchta rejimdan biri sifatida tavsiflanadi: aloq rejimi; teginish rejimi, shuningdek, tebranish rejimi deb ataladi.
Aloqa rejimi[tahrir | manbasini tahrirlash]
Aloqa rejimida mikroskop uchi namunaning yuzasi bo'ylab "tortib olinadi" va sirt konturlari to'g'ridan-to'g'ri konsolning egilishi yordamida yoki odatda konsolni doimiy holatda ushlab turish uchun zarur bo'lgan qayta aloqa signali yordamida o'lchanadi. Namuna yuzasiga yaqin joyda, jozibador kuchlar juda kuchli bo'lishi mumkin, bu esa uchining sirtga "yopilishiga" olib keladi. Aloqa rejimi AKM deyarli har doim umumiy kuch itaruvchi bo'lgan chuqurlikda, ya'ni qattiq sirt bilan qattiq "aloqada" amalga oshiriladi.
Bosish rejimi[tahrir | manbasini tahrirlash]

Bosish rejimida konsol o'zining rezonans chastotasida yoki yaqinida yuqoriga va pastga tebranish uchun boshqariladi. Ushbu tebranish odatda konsol ushlagichidagi kichik piezo element bilan erishiladi, ammo boshqa imkoniyatlarga o'zgaruvchan tokning magnit maydoni (magnit konsollari bilan), piezoelektrik konsollar yoki modulyatsiyalangan lazer nurlari bilan davriy isitish kiradi. Ushbu tebranishning amplitudasi odatda bir necha nm dan 200 nm gacha o'zgarib turadi . teginish AKM tasviri namuna yuzasi bilan uchining intervalgacha kontaktlarining kuchini tasvirlash orqali hosil bo'ladi.[8]
Bu maqola birorta turkumga qoʻshilmagan. Iltimos, maqolaga aloqador turkumlar qoʻshib yordam qiling. (Aprel 2024) |
- ↑ „Measuring and Analyzing Force-Distance Curves with Atomic Force Microscopy“. afmworkshop.com.
- ↑ Atomic Force Microscopy for electrical characterization.
- ↑ „Atomic Force Microscopy Research involving the study of Neglected Tropical Diseases“. www.afmworkshop.com.
- ↑ 4,0 4,1 Patent US4724318 – Atomic force microscope and method for imaging surfaces with atomic resolution
- ↑ Binnig, G.; Quate, C. F.; Gerber, Ch. (1986). „Atomic Force Microscope“. Physical Review Letters. 56-jild, № 9. 930–933-bet. Bibcode:1986PhRvL..56..930B. doi:10.1103/PhysRevLett.56.930. PMID 10033323.
- ↑ Binnig, G.; Quate, C. F.; Gerber, Ch. (1986). „Atomic Force Microscope“. Physical Review Letters. 56-jild, № 9. 930–933-bet. Bibcode:1986PhRvL..56..930B. doi:10.1103/PhysRevLett.56.930. ISSN 0031-9007. PMID 10033323.
- ↑ Roiter, Y; Minko, S (Nov 2005). „AFM single molecule experiments at the solid-liquid interface: in situ conformation of adsorbed flexible polyelectrolyte chains“. Journal of the American Chemical Society. 127-jild, № 45. 15688–9-bet. doi:10.1021/ja0558239. ISSN 0002-7863. PMID 16277495.
- ↑ Geisse, Nicholas A. (July–August 2009). „AFM and Combined Optical Techniques“. Materials Today. 12-jild, № 7–8. 40–45-bet. doi:10.1016/S1369-7021(09)70201-9.
